先进封装火了,芯片行业开始回暖?
当巨头们开始提前布局。
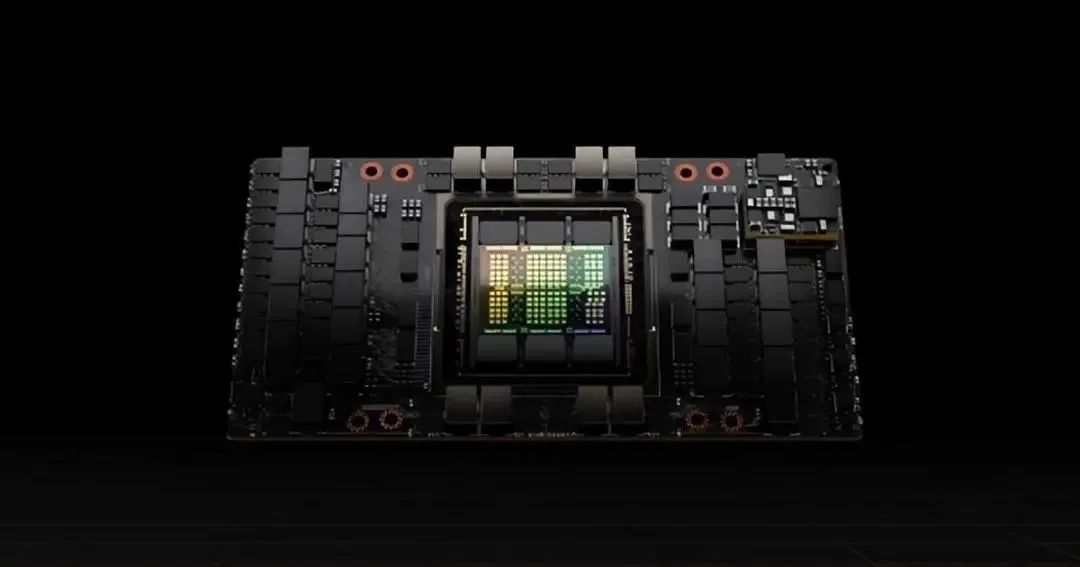
AI行业究竟有多火?
据台湾当地媒体报道,台积电的AI芯片产线已出现爆单状况。即使调整了制程,也无法满足客户需求。
对此,台积电在本周的一份声明中表示,计划投资近900亿新台币(合28.7亿美元)在新竹科学园区辖下的铜锣科学园区新建一家先进封装工厂,预定2026年底完成建厂,2027年第三季量产。
不过在新工厂建成前两年,依然消耗不完大客户的订单。并不是台积电没有制造能力,而是封装能力太吃紧。
芯片巨头,争抢先进封装订单
台积电在AI领域的大客户,无疑是英伟达。
靠着成熟的工艺制程,以及独特的CoWoS(Chip On Wafer On Substrate)封装工艺,台积电一直为英伟达GPU芯片提供封测服务。
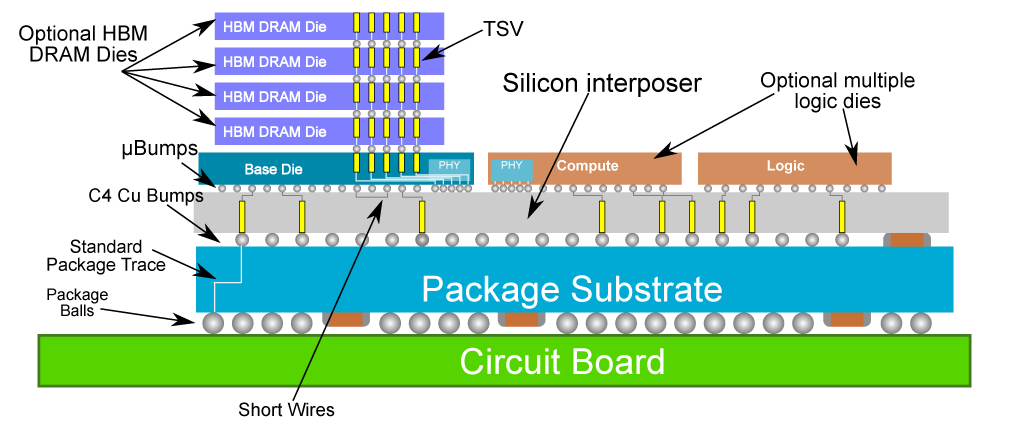
图 | 台积电最新CoWoS工艺
但台积电在制造能力跟得上,封装能力却成大难题。一方面,封装不是台积电的主业,几乎所有封装产能都在台湾当地;另一方面,台积电还要兼顾苹果、AMD、英特尔等大客户的封装订单,能留给英伟达的产能非常有限。
据报道称,目前台积电CoWoS月产能大约仅在8000~9000片,若加紧急预定的产能,每个月大约平均多出1000~2000片的产能。
然而随着AI浪潮的到来,包括亚马逊AWS、博通、思科和赛灵思在内的台积电客户都提高了CoWoS封装需求,台积电的产能瞬间告急。
面对封装这块“短板”,黄仁勋在6月的台北电脑展上表示,会力求更加多元化的供应链。一时间,头部厂商纷纷抢滩,加注封装产能,这当中不仅有日月光、Amkor这类老牌封测厂,也有三星、英特尔、联电等代工巨头。
有消息称,英伟达目前已经寻找到了二供,三星先进封装团队(AVP)有望拿下一笔封装订单,Amkor、日月光旗下矽品都是潜在的二级供应商/替代供应商。如果一切顺利,英伟达一部分AI GPU封装将由二供负责。
看到封装潜力的不仅是头部企业,韩国政府也在为本国先进封装产业规划项目。
据悉,该项目总成本规划为300亿至5000亿韩元, 韩国政府目前正在调查企业参与该项目的意愿及实力。该项目暂定名称为“半导体先进封装领先核心技术开发项目”,具体技术涉及2 .5D封装、3D封装、Chiplet、WLP、PLP等工艺。
先进封装,为什么火了?
我们都知道,摩尔定律失效已经成为业内共识,随着芯片工艺不断演进,后摩尔时代硅的工艺发展趋近于其物理瓶颈,晶体管想要变得更小就愈加困难。
既然芯片制程提升困难,那么从封装层面入手成了另一个思路。

台积电是较早投入先进封装方案研发的代工厂,其最具代表性的就是CoWos工艺,该工艺原本为移动端处理器开发的制程工艺,能够减少芯片70%的体积。
但早期的CoWos工艺价格非常昂贵,只有赛灵思一家客户使用,在升级为更为经济的InFO封装技术后,台积电终于迎来了超级大客户苹果,不仅打响了CoWos工艺的名声,也让行业看到了先进封装的潜力。

图 | 台积电封装工艺路线图
此后,各路先进封装工艺百花齐放,包括晶圆级封装、扇出型封装、SIP(系统级封装)以及SoIC(3D)等封装技术,这些先进封装不仅维持着摩尔定律的进展,同时也提升了封装具有更高的附加值,一改传统封装“薄利多销”的路线。
如今的AI时代,AI芯片对于先进分装的需求更加迫切。
随着运算需求的日益复杂,异构计算大行其道,更多不同类型的芯片需要被集成在一起,先进封装通过提升了芯片集成密度和互联速度的做法,大幅提升了相关产品的内存容量和数据传输速率。

因为,我们注意到各家厂商开始在先进封装市场展开竞争,本质上还是看到背后强大的市场需求。
市场急需强心剂
AI火了,让GPU吃上了红利,相关AI芯片、算力芯片都成为当下的“香饽饽”。但目前来看,只有英伟达成了赢家,其他的芯片厂商仍未逃脱下行周期魔咒。
上周四,台积电公布了最新的财报,数据显示,台积电第二季度收入同比下降近10%。这是该公司16个季度以来首次出现收入下滑,而此前台积电创造了自2000年以来持续时间最长的一次增长。
其中有一个非常值得注意的数据,二季度HPC(高性能计算)业务为台积电贡献了44%的营收,远高于智能手机的贡献量。
但相较于一季度并未有太大起伏,数值上甚至还低了4.4亿美元,足以看出AI芯片市场需求不及预期。
不夸张地说,台积电的业绩其实是全行业健康状况的一个有力风向标——在消费电子持续的背景下,颓势仍未到拐点,虽然AI芯片确实很火,但还不足以改变芯片行业的现状。

与消费电子和服务器市场相比,AI芯片的体量还是太小。正如魏哲家此前在今年4月的投资者电话会议上所说:“我们此前曾预测HPC的年化增长率是15%到20%,但是AI的机遇还不足以让我们给这个数字增加点什么。”同时,魏哲家对AI市场的热情表示谨慎。
当然,AI芯片的增长势头还是相当不错的,不仅弥补了消费电子芯片留下的空缺,同时也促使芯片巨头们开始对先进封装工艺的布局。
对比制造环节的制程工艺,先进封装工艺其实更像是一种辅助手段,有了前者再有后者。例如基于Chiplet的3D先进封装,本质上还是一项整合技术,有了小芯片才能进行下一步封装。
但同时,我们也可以反过来看——先进封装技术也会拉进各环节的配合,不仅降低了晶圆厂的制造门槛,也可以改进设计公司的思路。
另一方面,在行业回暖之前,芯片巨头们度过这个冬天的手段并不多,提前布局先进封装,为需求爆发打好基础,并不是一件坏事。
最后,记得关注微信公众号:镁客网(im2maker),更多干货在等你!
硬科技产业媒体
关注技术驱动创新
 博通处理器思科服务器消费电子
博通处理器思科服务器消费电子 
 微信ID:im2maker
微信ID:im2maker 长按识别二维码关注
长按识别二维码关注